테이퍼 형태의 경사벽을 갖는 비아 홀 제조 방법
페이지 정보
최고관리자 0 Comments 1 Views 20-11-10 15:46 기계본문
- 분야 : 기타 개발상태 9
기술완성도
-
TRL09
사업화
- 본격적인 양산 및 사업화 단계
-
TRL08
시작품 인증/
표준화- 일부 시제품의 인증 및 인허가 취득 단계
- 조선 기자재의 경우 선급기관 인증, 의약품의 경우 식약청의 품목 허가 등
- 일부 시제품의 인증 및 인허가 취득 단계
-
TRL07
Pilot 단계 시작품
신뢰성 평가- 시작품의 신뢰성 평가
- 실제 환경(수요기업)에서 성능 검증이 이루어지는 단계
-
TRL06
Pilot 단계 시작품
성능 평가- 경제성(생산성)을 고려한, 파일로트 규모의 시작품 제작 및 평가
- 시작품 성능평가
-
TRL05
시제품 제작/
성능평가- 개발한 부품/시스템의 시작품(Prototype) 제작 및 성능 평가
- 경제성(생산성)을 고려하지 않고, 우수한 시작품을 1개~수개 미만으로 개발
-
TRL04
연구실 규모의
부품/시스템 성능평가- 연구실 규모의 부품/시스템 성능 평가가 완료된 단계
- 실용화를 위한 핵심요소기술 확보
-
TRL03
연구실 규모의
성능 검증- 연구실/실험실 규모의 환경에서 기본 성능이 검증될 수 있는 단계
- 개발하려는 시스템/부품의 기본 설계도면을 확보하는 단계
- 모델링/설계기술 확보
-
TRL02
실용 목적의 아이디어/
특허 등 개념 정립- 실용 목적의 아이디어, 특허 등 개념 정립
-
TRL01
기초 이론/
실험- 연구과제 탐색 및 기회 발굴 단계
- KEYWORD
-
표면, TSV기술, 테이퍼 형태, 소형화, 고집적화
- 기술개요
-
형상왜곡이없는경사벽을가진비아홀을제공하여, 비아홀표면거칠기를개선하는테이퍼
형태의경사벽을갖는비아홀제조방법
✓ 비아 홀(Via Hole): 여러 층의 기판을 전도성 물질로 연결하는 통로의 개구부 구멍(hole)
✓ 테이퍼 형태: 끝으로 갈수록 폭이 점점 좁아지는 형태( )
- 주요 기술내용
-
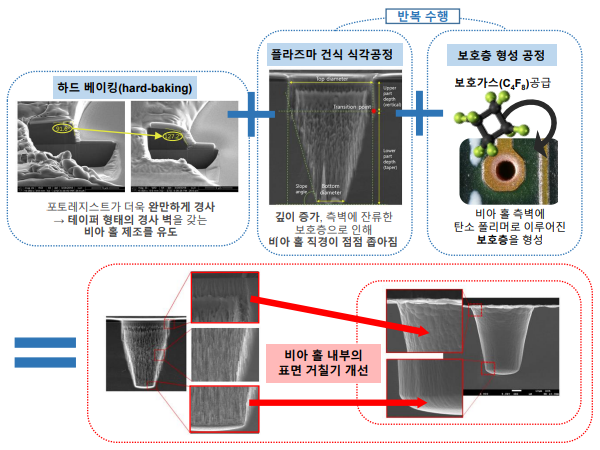
- 시장 및 기술동향
-
- 3D TSV 및 2.5D 시장은 2021년부터 2026년까지 예측 기간동안 35.3%의 CAGR을
기록할 것으로 예상됨
- 현재 TSV형성 및 패키지와 관련하여 다양한 연구결과가 발표되었으며, 수율 향상,
테스트방법론 개발, 신뢰성 확보를 위해 산업계가 경쟁 중
- 반도체 패키징 세계시장은 연평균 4%이상의 지속적인 성장할 것으로 전망되고, 특히
패키징 분야에 대한 기술 변화가 예상됨
- 기술활용 분야
-
✓ 패키지 공정 PCB(반도체 패키지 기판)을 사용하는 모든 분야

Apple Watch
- 기술활용 분야
-
✓ 소형 반도체–웨어러블 기기, IoT기반 가전 제품, 헤드셋 등

자동차 전조등
- 기술활용 분야
-
✓ 메모리 장치-DRAM, NAND 플래시, 서버MPU

바이오 센서
- 특장점
-
- 원활한 후공정 수행 可
- 이후공정으로씨드층및전기도금이비아홀 측벽으로균일하게증착되어우수한스텝 커버리지(step coverage)모양을가짐
- 공정단순화및생산비용절감
- 비아홀의형상왜곡을방지하여추가식각 공정과같은추가공정불필요

